
应用于卫星或空间飞行器等电子系统中的半导体器件,将会不可避免地受到空间辐射环境的影响。
空间辐射环境主要来源有 3 个:①地磁场俘获带(也称范·艾伦辐射带(Van Allen Belt)),主要由电子和质子组成;②太阳宇宙射线,主要由质子(90%~95%)和氦粒子组成;③银河宇宙射线,主要由质子(85%)、氦粒子(1%)和高能重粒子(1%)组成。
复杂的空间辐射环境将会对应用于航天电子系统中的半导体器件产生辐射效应,从而引起半导体器件的性能退化甚至是功能失效,最终将严重影响航天器的可靠性及在轨寿命。
太空辐射环境对半导体器件的辐射破坏主要有 3 种方式:①电离总剂量辐射效应(Total Ionizing Dose,TID);②单粒子效应(Single Event Effects,SEES);③位移损伤(Displacement Damage,DD)。其中,质子主要产生总剂量电离损伤、单粒子效应和位移损伤,电子主要产生总剂量电离损伤,而高能粒子主要产生单粒子效应。另外,电离总剂量辐射效应和单粒子效应统称为电离效应。
半导体器件作为航天器的基本组成单位,其抗空间辐射能力的强弱在很大程度上决定了在轨航天器的使用寿命和可靠性。因此,在恶劣的空间辐射环境下,为保证航天器的安全可靠性和确保飞行任务的顺利实现,必须选用达到相应辐射等级的半导体器件。空间环境辐射试验技术是在地面检验半导体器件抗空间辐射能力极其重要的手段,对于保证航天器的安全及可靠性具有极其重要的意义。
一、概述
辐射粒子穿进物质,与物质中的电子相互作用,把自身的能量传给电子,如果电子由此获得的能量大于它的结合能(有效的激发要求入射辐照粒子的能量高于材料禁带宽度的 3倍),电子就脱离原子核对它的束缚成为自由电子,而原子则变成了带电离子(也可视为原子获得了一个空穴,从而形成电子-空穴对)。这一过程称为电离辐射效应。快中子流、高能电子、γ射线和X射线等均可引起电离效应,γ射线和X射线等光子流更容易引起材料电离,γ射线的电离效应最为显著。
带能量的光子(γ射线及 X 射线)同固体相互作用时,电离损伤是主要的损伤机理。当光子入射材料时,依据光子能量不同,与靶原子可以产生三种相互作用的物理过程:①光电效应;②康普顿散射效应;③电子对效应。
低能光子和物质发生作用主要是通过光电效应。入射光子的能量完全被吸收,同时激发一个电子到一个高能态,就产生了一个自由的光电子和一个带正电的原子核。
对于高能光子,康普顿散射占主导地位。在这个过程中,一个光子和原子碰撞时,光子把一部分能量传给目标原子的一个电子,使这个电子有足够的能量离开原来的原子。康普顿散射的结果是产生了一个低能光子,同时也产生了一个自由电子和一个电离原子核。
电子空穴对效应通常是对极高能量的光子而言的,在此过程中,入射光子和目标原子碰撞后产生一个正负电子对,正电子和电子有相同的特性(电荷量和大小),不同之处仅在于它带正电。入射光子在这个过程中完全被湮没。
光子3 种效应随物质的原子序数Z和光子能量变化的相对重要性如图1 所示。图中实线为相邻效应的等作用截面线,虚线表示光子与硅(Z=1)相互作用的情况。可以看出,对于硅材料在能量小于 50keV 时,光电效应起主要作用,当能量大于 20MeV 后,电子对生效应起主要作用,在中间的能量范围,则以康普顿散射效应为主。
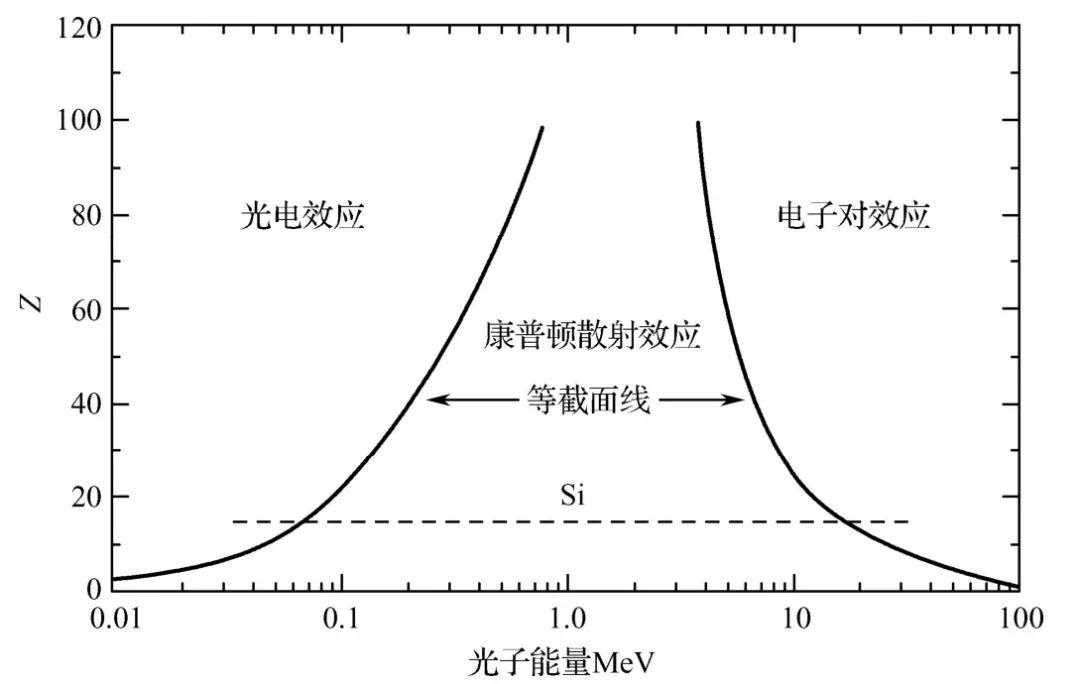
图1 光子3种效应随原子序数Z和光子能量变化的相对重要性
实验室使用的钴 60γ射线源释放的γ射线的能量有两种:1.17MeV 和 1.33MeV。因此,γ射线与物质的作用主要是康普顿散射,产生康普顿电子。
X射线的能量一般比较低,通常为几keV到近百keV,因此,X射线与物质的作用主要是光电效应。
1.电离总剂量辐射效应
电离总剂量辐射效应是指电离辐射的累积导致器件的参数发生退化的现象。
半导体器件主要分为MOS器件、双极器件两类。对于MOS器件,无论是硅栅器件还是金属栅器件,在栅和衬底之间有一层SiO2介质,其与衬底Si将构成Si-SiO2系统;而双极器件均采用SiO2钝化层(氧化层)保护器件表面,其钝化层与衬底Si也将构成Si-SiO2系统。电离总剂量辐射效应的基本机理是电离辐射在 Si-SiO2系统中产生氧化物陷阱电荷(Not)和界面态(Nit),辐射产生的氧化物陷阱电荷(Not)和界面态(Nit)使器件的性能参数发生退化。辐射在 Si-SiO2 系统中产生氧化物陷阱电荷(Not)和界面态(Nit)的基本过程如图2所示。

图2 辐照下Si-SiQ2系统中的反应过程和主要缺陷
在辐射过程中,SiO2吸收射线能量而被电离,产生大量的电子-空穴对(过程 1)。大部分电子-空穴对在约 10^-12s 即皮秒(ps)的时间内发生复合(过程 2)。逃离初始复合的电子-空穴对在氧化物中电场的作用下分离(过程 3)。电子由于迁移率远高于空穴,其会在很短的时间内被扫出氧化物层。剩余的空穴将会缓慢地向界面处运输(过程 4)。当空穴缓慢运动到界面附近时将会被界面的氧空穴缺陷(空穴陷阱)俘获,形成氧化物陷阱电荷(过程 5),带正电荷。此外,另一个主要的反应过程是界面陷阱(辐射感生界面态)的形成。当空穴以“跳跃”输运到界面附近时,会发生一系列的反应,生成辐射感生界面态(过程 9),而且辐射感生界面态的形成与SiO2钝化层(氧化层)中的H离子也有很大的关系。
1)氧化物陷阱电荷(Not)的特性
如上所述,氧化物陷阱电荷(Not)是由于空穴在界面处被空穴陷阱俘获所形成的,带正电荷。
在电离辐射过程中,氧化物陷阱电荷(Not)将会快速地大量产生,但是辐射产生的氧化物陷阱电荷(Not)并非永久保持着,而是会经历一个与时间相关的退火过程。
氧化物陷阱电荷(Not)的退火过程,实际上就是氧化物陷阱电荷(Not)消失的过程。氧化物陷阱电荷(Not)的退火过程主要分为隧道退火和热退火。隧道退火指的是由于衬底 Si中的自由电子的隧穿效应,进入 SiO2 中与氧化物陷阱电荷(Not)复合的过程,此过程与界面势有关,也即与外加偏置有关。热退火指的是空穴受热激发到价带而脱离陷阱的过程,此过程与温度有很大的关系。
研究表明,室温下氧化物陷阱电荷(Not)就会发生缓慢的退火效应,当温度达到 100℃时,氧化物陷阱电荷(Not)将会发生大量退火。
在电离辐射的过程中,氧化物陷阱电荷(Not)的产生和退火是两个相对独立而又同时存在的过程。电离辐射结束后,氧化物陷阱电荷(Not)也会继续退火。
2)界面态(Nit)的特性
辐射感生界面态的过程,就是 Si-SiO2 界面处存在大量弱键在辐射作用下断裂成悬挂键的过程。界面态(Nit)可以分为施主型和受主型两类。辐射感生界面态(Nit)所带电荷的极性与衬底Si的掺杂有关。
辐射感生界面态(Nit)的产生和氧化物陷阱电荷(Not)不一样,辐射感生界面态(Nit)的产生与时间有很大的关系,而且在电离辐射结束后也依然会产生。而且常温下,辐射感生界面态(Nit)的生成速率非常缓慢。
另外,辐射感生界面态(Nit)的退火和氧化物陷阱电荷(Not)也不一样。研究表明,辐射感生界面态(Nit)在常温下并不发生退火效应,当温度高于 125℃时,辐射感生界面态(Nit)才会开始发生退火效应。
2.电离总剂量基本单位
1)总剂量(吸收剂量)
总剂量(吸收剂量)定义为单位质量材料所吸收的任何电离辐射的平均能量,也称为吸收剂量。
吸收剂量的 SI 单位(国际单位制)为 1J/kg,其专用名为“戈瑞”,符号为“Gy”,其中1Gy=1J/kg。即1Gy等于1kg受照射物质吸收1J的辐射能量。
吸收剂量另外一个常用单位为拉德(rad),其与戈瑞(Gy)之间的换算关系如下:1rad=0.01Gy
必须指出的是,这里定义的吸收剂量适用于任何电离辐射及收照射的任何物质。但是不同种类的物质,其吸收辐射能量的能力是不同的,因此,凡是提到吸收剂量,必须指明是什么物质的吸收剂量,一般的表示方法为 rad(物质名称)。如 rad(Si)表示 Si 材料吸收的辐射能量大小;rad(H2O)表示水吸收的辐射能量大小。
2)吸收剂量率(剂量率)
吸收剂量率指的是材料吸收辐射能量的速率,也就是单位时间内吸收的辐射能量的大小。
吸收剂量率的SI单位为Gy/s,常用单位为rad/s。
同吸收剂量一样,凡是提到吸收剂量率必须指明是什么物质的吸收剂量率。
3.电离总剂量辐照源及试验设备
半导体器件对辐射非常敏感,为保证电子设备在特定的辐射环境下能正常工作,必须对它们的辐射效应及辐射加固进行研究。利用卫星搭载飞行试验的空间辐射进行电子元器件的辐射效应和加固技术研究具有真实性和综合性,但受条件的限制,在试验规模和测试的安排上等都有较大的困难,且试验次数有限。因此,利用实验室模拟辐射环境对电子元器件进行各种辐射试验研究便成为最方便和直观的方法。
对于半导体器件的电离总剂量辐照试验,目前实验室最常用的模拟源为 60Co-γ射线源,另外还有X射线源和电子加速器。
X 射线与γ射线对电子元器件的辐射损伤机理是相同的。但是由于 X 射线辐照存在很强的剂量增强效应和初始电子空穴复合因素,再加上 X 射线辐照装置的能谱、剂量测量都比较困难,因此,在进行总剂量辐照试验时,通常不会采用 X 射线源,而是大多采用 60Co-γ射线源。而且由于 60Co-γ射线源的能谱比 X 射线更好地匹配于空间辐射的能谱,因此,在进行空间环境总剂量效应试验中,是以 60Co-γ射线源为主。
1)60Co-γ射线源
60Co-γ射线源是一种稳态辐射源。60Co 是钴元素的同位素,其半衰期为 5.27 年。60Co 源在衰变的过程中会放出两束γ射线,其能量分别为 1.17MeV 和 1.33MeV,因此又叫 60Co-γ射线源。由于散射的缘故,60Co-γ射线源的射线能谱中除上述两种γ射线外,还包含大量的低能成分。这些低能成分同 X 射线一样,均会引起剂量增强效应,因此,电离总剂量试验过程中,需要对低能散射部分进行屏蔽。
γ射线具有极强的穿透性、射程大的优点,这将有利于对比较厚的物体进行总剂量试验。
60Co-γ射线源按照排列方式来分,主要可分为棒源、花篮源和板状源三类。如图 3~图5所示是3种形状的钴源的示意图。

图3 花篮源(环状源)

图4 板状源

图6 棒源
棒源指的是由单根源棒组成的钴源;花篮源是由多根源棒排列成花篮状的钴源;而板状源指的是将多根源棒按一定的间隔距离进行排列组成的钴源。棒源和花篮源具有剂量分布均匀性好的特点,因此,通常称棒源和花篮源为点源,相对的称板状源为面源。
表 1所示为国内主要的半导体器件电离总剂量辐照试验用 60Co-γ射线源。

表1 国内主要的半导体器件电离总剂量辐照试验用 60Co-γ射线源
2)剂量测试系统
所谓剂量测试系统,指的是电离总剂量辐照试验过程中对辐照剂量率和辐照总剂量进行测量的装置和方法。剂量测试系统的准确性和有效性是电离总剂量辐照试验的基础。
理论上来说,受辐射物质中所引起的效应与吸收的辐射剂量,如电离、发热、发光等各种物理变化、氧化还原、裂解、聚合等许多化学变化或由此引起的物理性质的变化,都可以作为辐射剂量测量的依据。目前主要的吸收剂量的测量方法有量热法、电离室法、化学法等。
量热法是一种直接测定吸收剂量的绝对方法。其基本原理是,被辐照的物质所吸收的辐射能量全部用来使被辐照物质的温度升高,这样就可以通过测量被辐照物质温度的变化来确定所吸收的剂量。热释光剂量计就是采用量热法的一种剂量计,其材料为CaF2。
电离室是由处于不同电位的电极和限定在电极之间的气体(一般为空气)组成,通过收集因辐射在气体中产生的电子或离子运动而产生的电信号来定量测量电离辐射的探测器。图7所示为电离室剂量仪实物。

图7 电离室剂量仪
化学法是利用辐射在体系中引起的化学变化与体系吸收的辐射能量之间的定量关系来测定吸收剂量的方法,如硫酸亚铁剂量计。硫酸亚铁剂量计又名 Fricke 剂量计,它是一种使用广泛、精度高、稳定性好的一种化学剂量计。
正如前面所述,凡是提到吸收剂量,就必须指明是何种物质的吸收剂量。因此,用剂量计测得的剂量只代表该剂量计的吸收剂量。例如,Fricke 剂量计测得的吸收剂量是硫酸亚铁的吸收剂量;空气电离室测得的吸收剂量是空气的吸收剂量;热释光(CaF2)剂量计测得的吸收剂量是CaF2的吸收剂量。
对半导体器件来说,吸收剂量通常是以Si吸收的剂量来表征,因此,进行试验时,均需将上述剂量计测得的吸收剂量转化为Si的吸收剂量。
二、宇航用半导体器件电离总剂量试验标准
1.国外相关标准分析
在半导体器件总剂量辐照试验方面,国外主要总剂量辐照试验标准如表2所示。

表2 国外总剂量辐照试验标准及方法
表 3 总结了ESA/SCC22900 和 MIL-STD-883H 方法 1019.8 的不同之处。可以看出,ESA/SCC22900 和MIL-STD-883G 方法 1019.7 在试验的适用范围、辐射源的选择、辐射总剂量的要求、辐射剂量率、退火条件及辐射过程中的温度和测试温度存在差别,而在辐射剂量率的选择上,两标准的规定相差几十倍。


表3 元器件总剂量辐射试验标准(国外)分析
ESA/SCC22900和MIL-STD-883方法1019.7不仅在剂量率的选择上存在差异,在试验程序上也存在不同,如图8和图9所示。根据ESA/SCC22900的规定,当MOS工艺的器件进行总剂量辐照试验时,应选择 1~10rad(Si)/s 的标准剂量率,辐射至规定的总剂量,不需进行50%额外剂量的辐射,具体试验程序如图8所示。根据MIL-STD-883方法1019.7的规定,当MOS工艺的器件进行TID试验时,应选定标准剂量率为50~300rad(Si)/s,辐射至规定的剂量,如果器件无功能失效,则应继续辐射 50%额外剂量后进行高温退火,具体试验程序如图9所示。
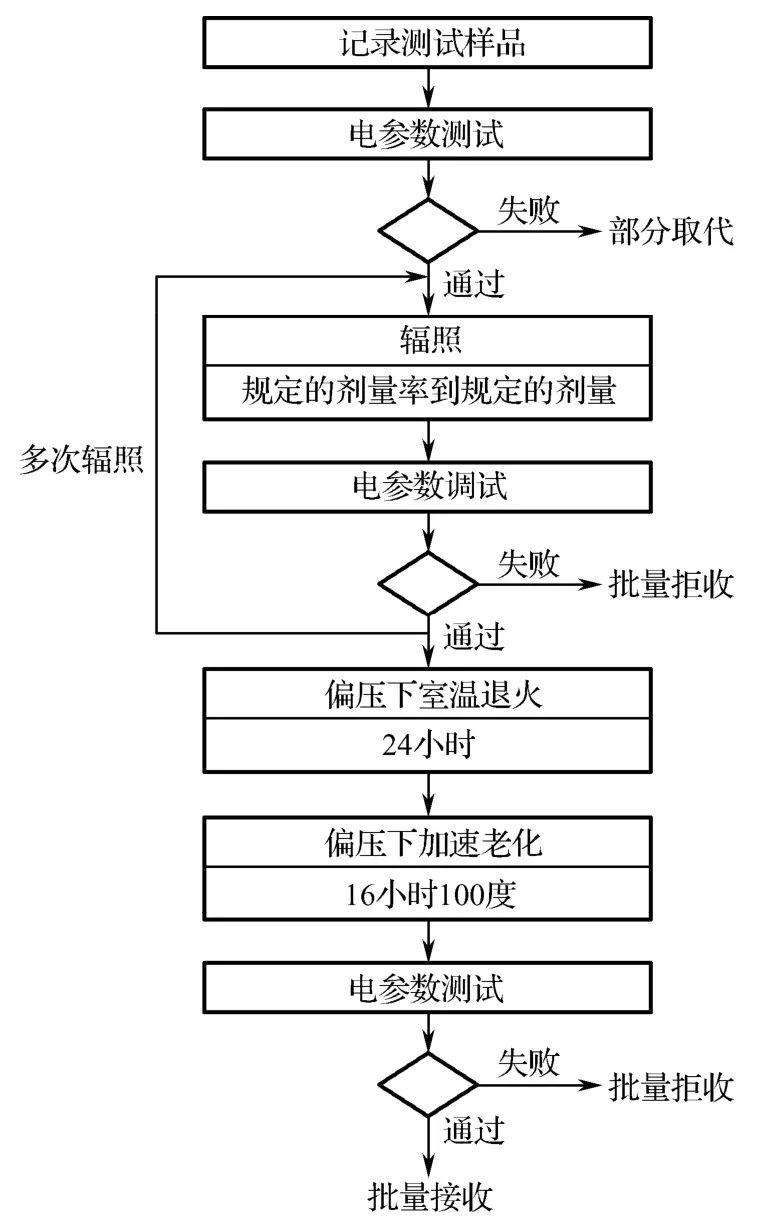
图8 ESA/SCC22900规定的总剂量辐照试验程序
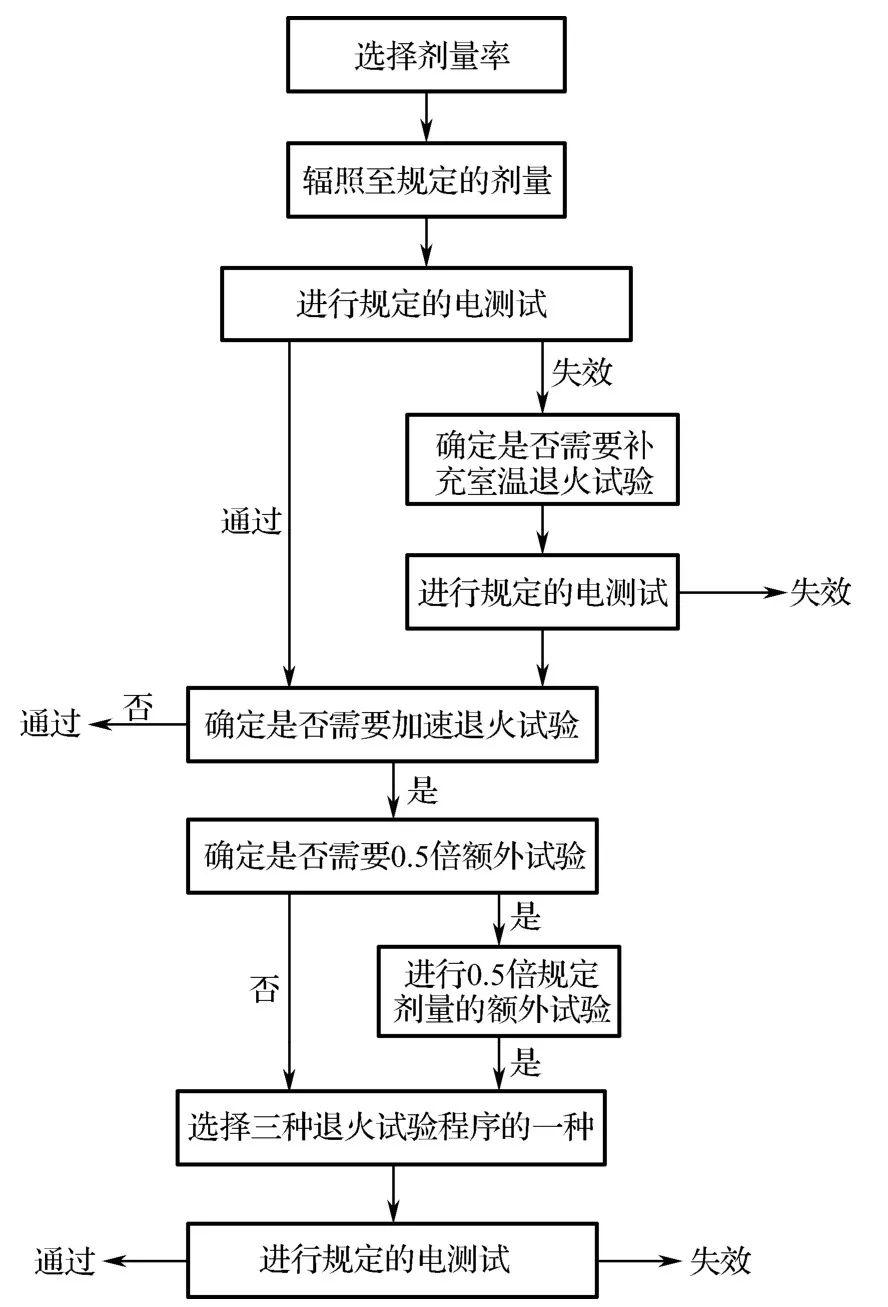
图9 MIL-STD-883G方法1019.7规定的总剂量辐照试验程序
2.国内相关标准调研分析
在半导体器件总剂量辐照试验方面,国内主要总剂量辐照试验标准如表4所示。

表4 国内总剂量辐照试验标准及方法
GJB 548B(等同MIL883)方法1019、GJB128A方法1019是现行的集成电路及分立器件总剂量辐照试验方法。QJ 10004 宇航用半导体器件总剂量试验方法是国内最新推出的针对宇航用半导体器件的总剂量辐照试验和程序。表4总结了GJB 548B方法1019、GJB 128A方法1019和QJ 10004的不同之处。可以看出,GJB 548B方法1019、GJB 128A方法1019和QJ 10004在试验的退火条件、试验时序及辐射过程中的温度和测试温度等存在差别。


表4 元器件总剂量辐射试验标准分析
三、宇航用半导体器件电离总剂量试验方法
1.空间低剂量率辐射环境
在地面上对半导体器件进行总剂量试验的最终目的是为了得到半导体器件在空间辐射环境中的抗辐射能力。因此,有必要详细了解空间辐射环境。
空间辐射环境是一种低剂量率辐射环境。在太空辐射环境中,器件在低地球轨道(LEO)的真实的辐射环境的剂量率为 10-6~10-5rad(Si)/s,在地球同步轨道(GEO)的真实辐射环境的剂量率为10-5~10-3rad(Si)/s。表5所示是几种典型轨道的电离辐射积累剂量。
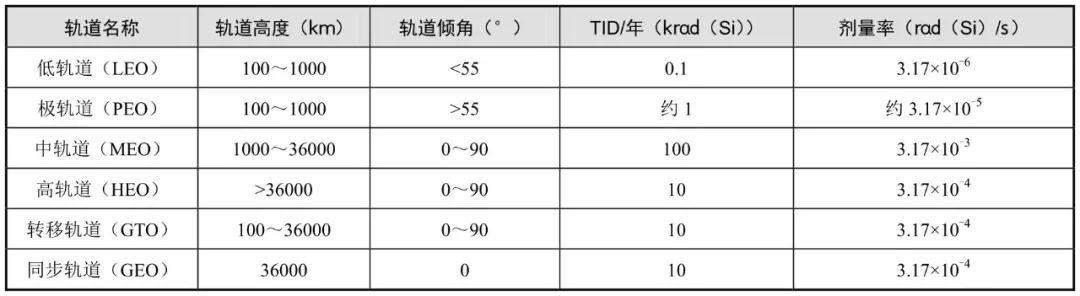
表5 几种典型轨道的电离辐射积累剂量
由上述可以看出,实际的空间辐射环境是一种低剂量率辐射环境。剂量率对半导体器件的总剂量辐射损伤有很大的影响,其中 MOS 器件表现为时间相关效应(Time Dependence Effects,TDE,也称时变效应);双极器件表现为低剂量率损伤增强效应(Enhanced Low Dose Rate Sensitity,ELDRS)。
所谓时间相关效应(TDE),指的是在辐照结束后,高剂量率经过与低剂量率辐照等时的退火后,由于界面态的后生长及氧化物陷阱电荷的退火,使得在退火结束时损伤程度与低剂量率的损伤程度相当。TDE效应示意图如图10所示。对MOS器件及采用CMOS工艺制造的器件,剂量率对器件的辐照损伤均表现为TDE效应。
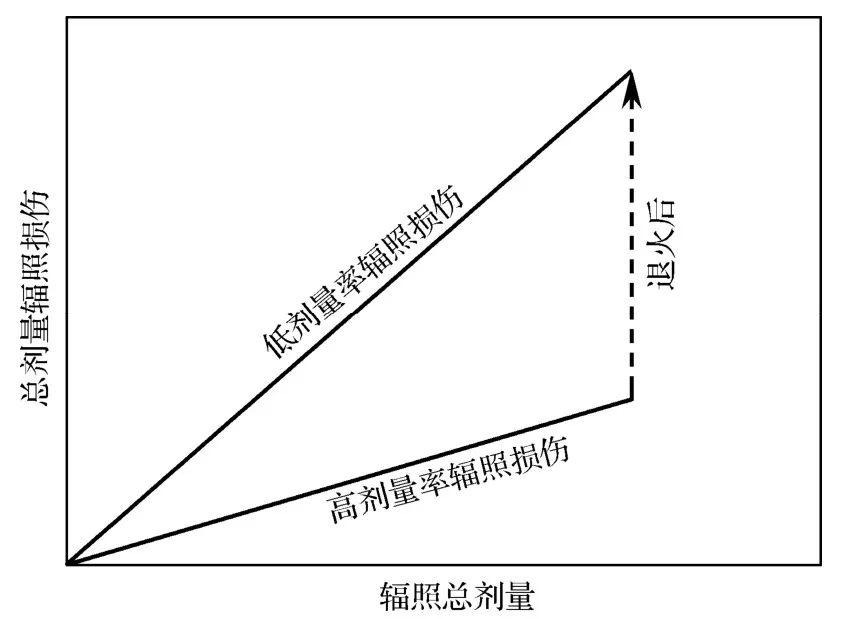
图10 TDE效应示意图
与 MOS 器件不同,对于大多数双极晶体管及双极器件而言,不同的剂量率辐照结果不是 TDE 效应,而是一种低剂量辐照损伤增强效应(Enhanced Low Dose Rate Sensitivity,ELDRS)。ELDRS 效应的表现形式为低剂量率辐射损伤比高剂量率辐射损伤更为显著,而且这种损伤并不能通过与低剂量率辐照等时间相同的环境温度下退火加以消除(若能加以消除,则为TDE效应)。
大部分双极器件和线性集成电路都具备明显的ELDRS效应。
因此,低剂量率空间辐射环境给半导体元器件抗辐射能力实验室测试评估方法带来了巨大的挑战。若采用实际的空间低剂量率对半导体器件的抗空间辐射能力进行评估,那么所花费的费用、时间将是巨大的,而且由于国内实验源的能力的限制,无法进行大批量的试验;若采用高剂量率(50~300rad(Si)/s)进行试验,一方面由于 ELDRS 效应的存在,无法模拟双极器件的低剂量率辐照损伤;另一方面,虽然对于 MOS 器件高剂量率辐照加长时间(与低剂量率辐照等时)的室温退火可以模拟低剂量率辐照损伤,但是其退火时间还是太长,耗费的人力物力还是太大。因此,需要一种加速评估方法来快速评估器件的低剂量率辐射损伤。
目前,对于 MOS 器件的低剂量率辐射损伤的加速评估方法如下:高剂量率辐照—过辐照—高温退火。国内对存储器的加速试验方法的研究表明,这种加速评估方法是严格考核存储器空间低剂量率辐射环境下TID效应的必要试验步骤。
对于双极器件,目前几种主要的加速评估方法如下:①高温高剂量率辐照法;②常温变剂量率辐照法;③变温辐照法;④氢气浸泡辐照法等。
2.MOS器件的加速评估方法
在GJB 548B—2005、QJ 10004—2008及MIL-STD-883H中给出了MOS器件的总剂量辐照试验流程(加速评估方法),具体流程如图11所示。
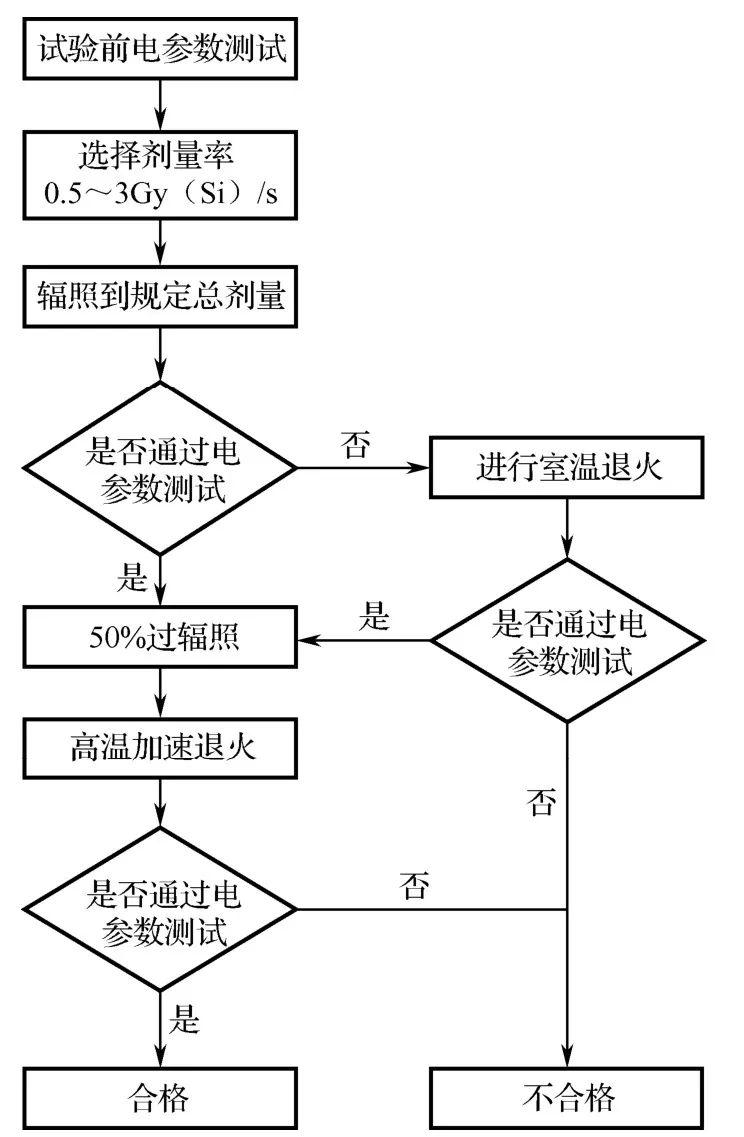
图11 MOS器件总剂量辐照流程
第一步:辐照剂量率选用高剂量率50~300rad(Si)/s。
第二步:辐照到规定的总剂量。
第三步:进行电参数测试,若合格,则进行第五步;不合格,则进行第四步。
第四步:进行 7 天的室温退火后,进行电参数测试,若合格,则进行第五步,不合格,则判为不合格。
第五步:进行50%的过辐照。
第六步:进行TA=100℃的168小时的高温退火。
第七步:进行电参数测试。
MOS器件的剂量率效应是时间相关效应,即高剂量率辐照加与低剂量率辐照等时的室温退火可以等效低剂量率的辐照损伤。也就是说时间相关效应是由于剂量率不同,所需辐照时间的长短不同,使辐照期间产生的氧化物电荷和界面态的数量存在差异。而且在高剂量率辐照后保持与辐照相同的偏置条件经过与低剂量率辐照到相同总剂量所需的时间的退火后,将会消除这种差异,最终高剂量率辐照损伤与低剂量率辐照上接近。
由于温度的升高将会加速氧化物陷阱电荷的退火,而且温度的升高将会使界面态的生长速度增加。因此,可以利用提高温度来使高剂量率辐照后的室温退火加速,进行 TA=100℃的168 小时的高温退火。由于第六步是为了加速高剂量率辐照后室温退火的过程,因此,第六步经常被称为MOS器件加速退火试验。
但是如果辐照到规定剂量直接进行加速退火试验,由于氧化物陷阱电荷对温度极度敏感,将会使加速退火试验后的氧化物陷阱电荷的数量要小于室温退火数量。为了补偿高温加速退火试验中额外发生退火的氧化物陷阱电荷的数目,需要在进行高温加速退火之前进行50%的过辐照,以进行补偿。
第三步中辐照到规定总剂量进行测试,若测试不合格,可以经过一段时间的室温退火后再行测试。这主要是因为高剂量率辐照后产生的氧化物陷阱电荷要明显高于低剂量率辐照,为了防止多出这部分的氧化物陷阱电荷引起的误判,允许经过室温退火后再进行测试。
3.双极器件的加速评估方法
与MOS器件不同,双极器件的剂量率效应表现为低剂量率损伤增强效应(ELDRS),也就是说高剂量率辐照后的室温退火无法消除与低剂量率的差异,ELDRS 效应的机理和 TDE效应的机理存在很大的区别。因此,GJB 548B、QJ 10004及MIL-STD-883H中给出的MOS器件的总剂量辐照试验流程(加速评估方法)将不适用于双极器件。
目前几种主要双极器件的加速评估方法如下:①高温高剂量率辐照法;②常温变剂量率辐照法;③变温辐照法;④氢气浸泡辐照法等。上述四种双极器件的加速评估方法仅适用于某些特定的器件,并不具备普遍适用性。
因此,对于双极器件的总剂量辐照试验,一般采用低剂量率的方式进行辐照试验。
4.宇航用半导体器件评估试验方法
宇航用半导体器件评估试验方法主要包含如下内容:①剂量率和试验流程的选择;②偏置条件的确定;③电参数测试的要求;④其他通用要求。
1)剂量率和试验流程的选择
由前文的介绍可以看出,剂量率对 MOS 器件和双极器件的影响完全不同,MOS 器件表现为 TDE 效应,大部分双极器件表现为 ELDRS 效应;MOS 器件可以采用通用的加速评估方法来模拟宇航低剂量率辐射环境的辐照损伤,而大部分双极器件只能采用低剂量率辐照的方式来评估低剂量率辐照损伤。也就是说,器件的类型和工艺决定辐照剂量率和试验流程的选择。
剂量率的选择如表6 所示。对同一批器件进行多次辐照试验和电参数测试时,辐照剂量率可以不同,但剂量率的变化不应超过10%。

表6 剂量率选择
宇航用半导体器件的试验流程分为两种:MOS 器件的试验流程(见图 11)和双极器件的试验流程(见图12)。
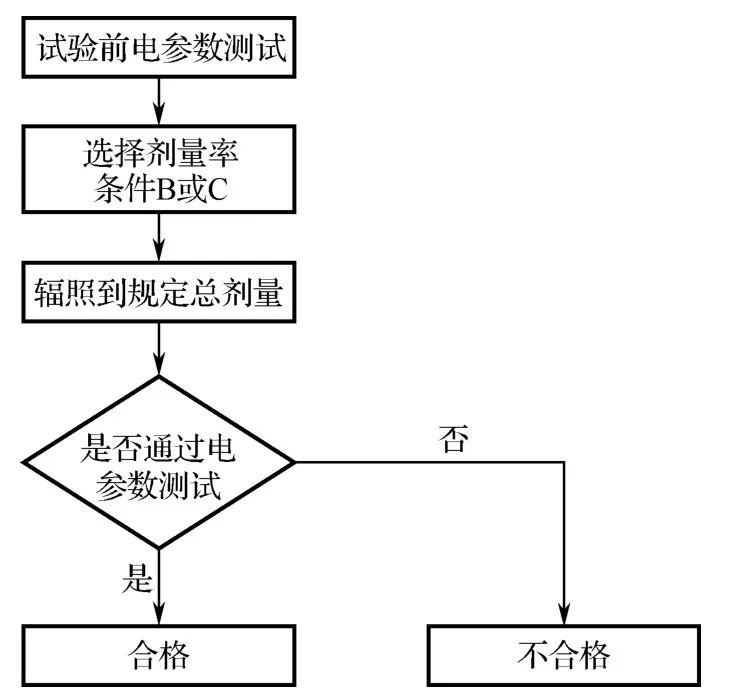
图12 双极器件试验流程
必须指出,剂量率的选择在一定程度上决定着试验流程的选择。表7所示为几种半导体器件进行电离总剂量辐照试验时的剂量率及试验流程的选择。

表7 剂量率及试验流程的选择
2)偏置条件的确定
总剂量辐照过程中器件的偏置条件是影响器件总剂量辐照损伤关键因素之一。器件的偏置条件决定了氧化层中的电场的强度和方向,氧化层中的电场的强度和方向影响着辐射感生电子-空穴对的分离(或初始复合率)和运动方向及速度(迁移率),从而影响着氧化物陷阱电荷和界面态的产生,最终影响器件的电离总剂量辐照损伤的大小。
总剂量试验标准中对辐照过程器件的偏置条件的规定如下:“辐照过程中器件加最劣偏置条件,或施加代表器件实际工作状态的偏置条件。”对大规模集成电路来说,确定器件的总剂量辐照最劣偏置条件往往是非常困难的,而且结构不同的器件的最劣偏置也不同。因此,在进行总剂量辐照时,需要进行大量的摸底试验或仿真分析试验以确定器件的最劣偏置条件。
另外,选择的负载应使器件结温上升少,以防止辐射退火效应的发生。
3)辐照后电参数测试
辐射产生的氧化物陷阱电荷在室温下就会发生退火效应,因此,为了减小退火效应对试验结果的影响,辐照后器件的电参数测试时间间隔一般遵守如下规定:
(1)辐照结束到开始电参数测试的时间间隔不得超过 1h;如果使用剂量率条件 C,时间间隔不得超过72h。
(2)上一次辐照结束到下一次辐照开始之间的时间间隔不得超过 2h;如果使用剂量率条件C,时间间隔不得超过120h。
为了减小退火效应的影响,这些时间间隔应该尽量短,且在试验过程中,电参数的测试顺序应保持不变。
另外,如果辐照后的电参数测试采用移位测试的方式进行,那么将器件从辐射源移至测试地点进行测试以及测试完毕返回辐射源继续进行辐照的过程中,应将器件的所有引脚短接,使辐射后的退火效应减至最小。
4)其他通用要求
(1)辐射源均匀性要求。器件被辐射的范围内测得的辐射场不均匀性应低于 10%,且整个辐照试验期间,辐射源的射线场强度大小(或剂量率)的变化不超过±5%。
另外,器件与辐射源之间位置的变化,以及辐射吸收和散射材料的存在将会影响辐射场的均匀性和强度。
(2)试验环境温度要求。温度对半导体器件的电离总剂量辐照损伤有很大的影响,因此,在进行辐照试验时,器件附近测得的环境温度应在(24±6)℃范围内。
(3)铅铝屏蔽盒要求。在辐照试验室中,一般都会有低能散射(低能射线)的存在,而且低能散射将会引起剂量增强效应,这将对评估结果造成影响。
因此,辐照试验过程中,器件应该放在铅铝屏蔽盒中,以较小由低能散射辐射引起的剂量增强效应。这种铅铝屏蔽盒外层要求至少为 1.5mm 厚的铅,内层屏蔽层至少为 0.7mm 厚的铝。
如果能证明低能散射辐射足够小,不会因剂量增强效应引起剂量测定的误差,也可以不使用铅铝屏蔽盒。
四、宇航用半导体器件电离总剂量试验案例
1.某型DDS器件的电离总剂量辐照试验
某型 DDS 器件(直接数字频率合成器),采用外延硅 0.13μm CMOS 工艺,6 层金属布线,器件内核工作电压为 1.2V,外部 I/O 工作电压为 3.3V,其引脚排列图如图 13 所示。因此,该器件采用MOS器件的试验流程进行试验,具体试验内容如下。

图13 某型DDS器件引脚排列图
1)辐射源选择
辐照源为钴60γ射线源。辐照场在试验样品辐照面积内的不均匀性小于10%。本试验的总剂量辐照源为中国科学院上海应用物理研究所的钴 60 γ射线源,或其他满足要求的辐照源。
2)试验环境要求
若无其他规定,所有试验应该在下列环境中进行:环境温度为 15℃~35℃;相对湿度为20%RH~80%RH。
3)试验样品选择及处置
样本数为2只/每晶圆。另外抽取一只样品不辐照作为对比样品,对比样品和辐照样品一起每次进行电测试。
4)剂量率及总剂量
剂量率为0.5Gy(Si)/s(±10%),规定总剂量为1000Gy(Si)。
5)电测要求
总剂量辐照试验前后的测试采用移位测试。在电参数测量时,先用对比样品进行测量系统检查,测试数据和被试样品的测试数据一起保存。辐照前、后的电参数测试应在同一测试系统上进行,测试项目的顺序和测试条件应保持不变,电参数测试的时间间隔遵守如下规定:
(1)辐照结束到开始电参数测试的时间间隔不得超过1h。
(2)上一次辐照结束到下一次辐照开始之间的时间间隔不得超过2 h。
如果辐照后的电参数测试采用移位测试的方式进行,那么将器件从辐射源移至测试地点进行测试,以及测试完毕返回辐射源继续进行辐照的过程中,应将器件的所有引脚短接。
6)偏置条件
试验过程中施加静态偏执条件,要求如下:
(1)器件的偏置电压端施加手册规定的电压;
(2)对于高电平有效的输入端,通过电阻上拉至电源电压;
(3)对于低电平有效的输入端,通过电阻下拉至地。
具体偏置条件如表8所示。
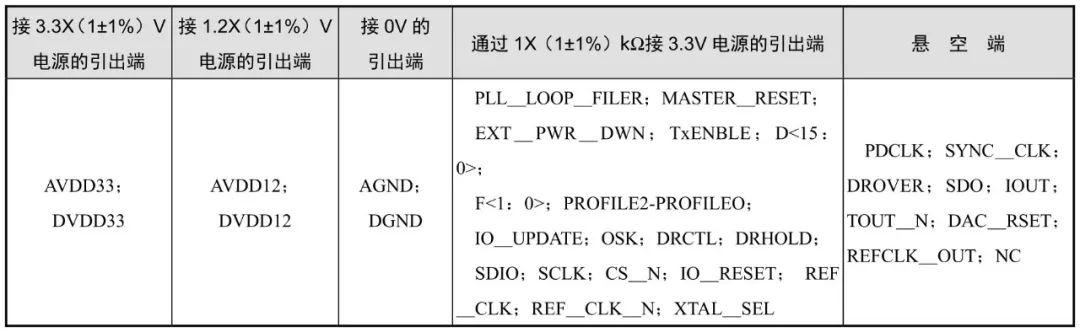
表8 具体偏置条件
7)试验流程
试验流程采用MOS器件试验流程进行,具体如下:
第一步:利用 UltraFLEX 型大规模数字集成电路测试系统对 3 只(其中一只对比备份样品)进行电参数测试,测试结果符合详细规范要求。
第二步:试验现场布置,根据选择的剂量率,将辐照试验板放置在制定的位置,并验证通信正常。
第三步:开始辐照试验,试验过程中每隔10krad(Si)记录电源电流一次。
第四步:当辐照总剂量达到 100krad(Si)时,辐照结束。将器件的引脚短接在一起,运输至电参数测试场所进行电参数测试。
第五步:进行电参数测试,测试结果符合详细规范要求。
第六步:测试完毕后,将器件的引脚短接在一起,运输至辐照地点,进行 50%过辐照追加试验。
第七步:辐照结束,维持辐照偏置条件进行TA=(100±5)℃ 168小时退火试验。
第八步:高温退火结束,进行最终点参数测试,测试结果符合详细规范要求。
2.某型DC/DC的电离总剂量辐照试验案例
DC/DC 属于混合电路,其内部既有 MOS 器件也有双极器件,在进行电离总剂量辐照试验时,不能采用 MOS 器件的试验流程,而是应该采用双极器件的试验流程。具体试验内容如下:
1)剂量率和总剂量
考虑到现实的试验周期及试验经费的原因,剂量率条件选择条件 B,剂量率为0.001Gy(Si)/s(±10%),规定总剂量为1000Gy(Si)。
2)电参数测试要求
总剂量辐照试验前后的测试采用移位测试。在电参数测量时,先用对比样品进行测量系统检查,测试数据和被试样品的测试数据一起保存。辐照前、后的电参数测试应在同一测试系统上进行,且测试项目的顺序和测试条件应保持不变,且电参数测试的时间间隔遵守如下规定:
(1)辐照结束到开始电参数测试的时间间隔不得超过1h;
(2)上一次辐照结束到下一次辐照开始之间的时间间隔不得超过2h。
如果辐照后的电参数测试采用移位测试的方式进行,那么将器件从辐射源移至测试地点进行测试,以及测试完毕返回辐射源继续进行辐照的过程中,应将器件的所有引脚短接。
3)试验流程
试验流程采用双极器件的试验流程进行,具体如下:
第一步:进行电参数测试,测试结果符合详细规范要求。
第二步:试验现场布置,根据选择的剂量率,将辐照试验板放置在制定的位置,并验证通信正常。
第三步:开始辐照试验,试验过程中每隔10krad(Si)记录电源电流一次。
第四步:当辐照总剂量达到100krad(Si)时,辐照结束。将器件的引脚短接在一起,运输至电参数测试场所进行电参数测试。

长按二维码识别关注我们

