
一、概述
空间辐射环境中存在的各种高能射线粒子,如质子、电子、α 粒子、重离子等。这些高能射线或粒子入射到半导体器件中时,会发生单粒子效应,导致器件失效。
单粒子效应又称单粒子事件(Single Event Effects,SEE),是高能粒子射入半导体器件后,由于电离效应所引起的一类辐射效应的总称,包括软错误和硬错误。单粒子效应按照效应的现象分为单粒子翻转、单粒子锁定、单粒子瞬态等多种,SEE 是包含所有单粒子效应的通用术语,几种典型的单粒子效应的缩略语如表1所示。

表1 几种典型的单粒子效应缩略语列表
(1)单粒子翻转(SEU),即高能粒子引起器件逻辑状态的改变,这种改变是可逆的。
(2)单粒子功能中断(SEFI),即高能粒子引起器件的功能异常。
(3)单粒子锁定(SEL,),即高能粒子引起CMOS器件的可控硅效应。
(4)单粒子烧毁(SEB),主要发生在功率器件中的空间辐射效应,将使器件发生不可逆的故障而失效。
(5)单粒子栅穿(SEGR),即高能粒子引起的栅极绝缘击穿。
前面两种效应(SEU、SEFI)为软错误。SEU 和 SEFI 仅仅改变了内部存储单元的状态,或者短时间内对器件中的某些节点产生一个干扰信号。此类效应可以通过对器件的复位,让芯片正常工作。
后面 3 种效应(SEL、SEB、SEGR)为硬错误或永久性损伤,这些效应会使器件中的晶体管彻底失效不工作。
1.单粒子效应的物理概念
1)注量率
注量率为单位时间内单位面积入射入器件的粒子数,单位为粒子数每平方厘米秒(粒子数/cm2·s)。
2)LET与有效LET
LET(Linear Energy Transfer,线性能量传输)的物理含义为单位密度单位长度上沉积的能量,也可以表示每单位轨迹长度上沉积的电荷数,单位为MeV·cm2/mg。
有效LET为粒子倾角入射时等效于表面法线方向上单位密度单位长度上沉积的能量,通常用LETeff表示,定义如下:

式中,θ为入射角度(与表面法线方向的夹角),LETθ为以θ角入射的离子的LET值。
LET 是能量的函数,随着能量的增加,LET 值增加,然后达到极大值,接着随能量的增加缓慢的下降。在高能区,LET值是能量的不灵敏函数,随能量改变的比较缓慢。图1所示为锗(Ge)离子入射入硅(Si)材料中,能量与LET的关系曲线图。

图1 Ge离子入射入Si中,能量与LET的关系曲线
3)单粒子效应截面σ(SEE Cross section)
单粒子效应截面 σ表示为单粒子事件发生的机率,定义如下:

式中,σ—单粒子事件截面,单位为平方厘米每器件或平方厘米每位(cm2/器件或cm2/位);
N—发生单粒子事件的数量;
Φ—注量(也称通量),为器件单位面积(cm2)入射的总的粒子数,单位为粒子数每平方厘米(粒子数/cm2)。
截面表示被测试器件的单粒子效应的敏感度,截面越大,表示器件抗单粒子效应的能力越差。
4)单粒子饱和截面与LET阈值
单粒子试验的目的是通过试验,获得器件单粒子事件截面σ与入射离子LET的关系曲线,为器件的在轨单粒子事件率(单粒子试验发生的几率)提供数据。
σ-LET 的关系曲线示意图如图 2所示。由图 2可以看出,随着入射粒子LET 值的增加,器件的单粒子截面将会不断增大。当入射粒子的LET 值达到某一值后,继续增加入射粒子的LET 值时,器件的单粒子截面将不会再增加,该截面称为单粒子饱和截面σsat。
LET 阈值定义为在给定的注量下,使器件发生单粒子事件的最小的 LET 值。但是由于试验设备及试验资源的原因,实际试验过程中,通过辐照试验得到器件发生单粒子事件的最小的 LET 值往往比较困难,因此,标准中又将 LET 阈值定义为 1%饱和截面所对应的LET值。
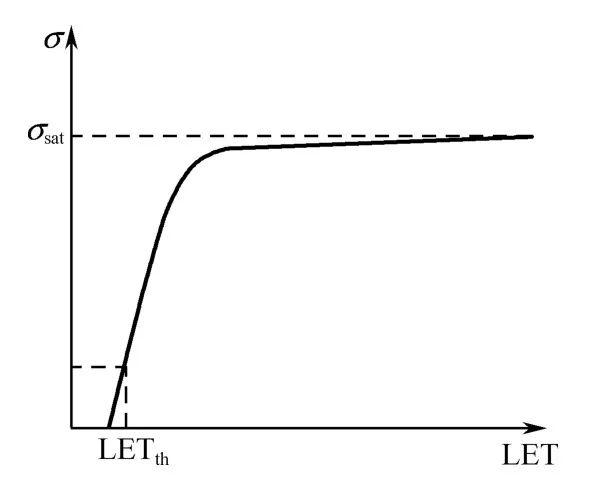
图2 σ-LET的关系曲线示意图
2.单粒子试验源
目前单粒子效应的研究手段为地面辐照源模拟。地面模拟单粒子效应的主要辐照试验装置有如下几种:①重离子加速器;②锎(252Cf)源;③脉冲激光源。
重离子加速器可以提供多种能量可变(LET 可变)的多种离子,能量高,射程长,可以很好地满足单粒子效应试验的要求。重离子加速器所产生的高能重离子可以直接对器件进行单粒子效应的地面模拟,即利用人为环境测得的效应来推测空间天然环境下的效应。利用重离子加速器进行单粒子试验的优点如下:环境条件可以人为控制;可以选择离子的种类、能量、强度,可以进行多次反复的试验;试验周期短,所需费用少。与空间实际条件相比,加速器离子的通量高,在空间需要很长时间累积的通量在加速器上很短时间即可达到。加速器的离子的能量远低于宇宙射线的能量,加速器离子与实际宇宙射线的离子只是具有相同的LET值,即LET值等效,而非能量等效。可进行单粒子试验的重离子加速器主要为中国原子能科学研究院的串列静电加速器和中国科学院近代物理研究所的回旋加速器。
锎(252Cf)源为 252Cf元素自发裂变碎片源,裂变产物的平均LET约为43MeV·cm2/mg,在硅中射程约为 15μm。由于锎(252Cf)源的射程短,采用锎源进行单粒子试验将会影响器件抗单粒子能力的试验结果。锎源可以定性地预估器件的单粒子敏感性,但无法准确地定量地评估器件的抗单粒子能力。因此,一般不采用锎源作为标准中的合格源。
脉冲激光源模拟单粒子效应的原理和重离子不同。激光主要是利用光电效应,在材料中产生电荷的轨迹不同于重离子,所测得的单粒子效应数据不同于重离子导致的单粒子效应试验数据,所以,需要进行大量反复的试验,找出脉冲激光源与重离子辐照的单粒子效应数据之间的等效性,才能制定可行的试验程序和方法。而且激光无法穿透金属层,对于灵敏区在金属下面的器件,无法给出准确的结果。
二、单粒子效应试验标准
单粒子试验标准如表2所示。

表2 国内单粒子试验标准
GJB 7242—2011 和 QJ 10005—2008 是国内半导体器件进行重离子单粒子效应试验的通用标准。GJB 7242—2011 是国家军用标准,而 QJ 10005—2008 是航天行业标准,二者的内容基本相同,其主要内容如表3所示。

表3 国内单粒子效应通用试验标准通用要求
关于单粒子试验流程,GJB 7242—2011 中给出了单粒子翻转(SEU)和单粒子锁定(SEL)试验流程示意图,具体流程如图3和图4所示。
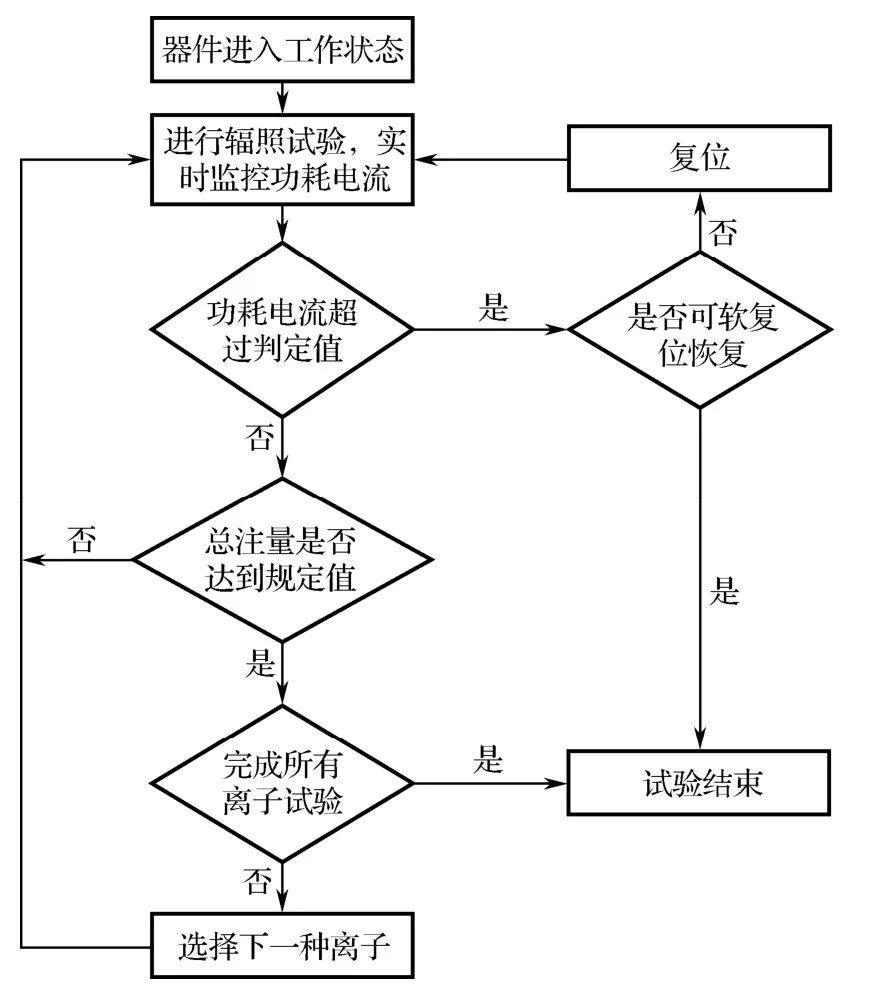
图3 单粒子锁定(SEL)试验流程示意图

图4 单粒子翻转(SEU)试验流程
由于每一种器件的单粒子效应的表征形式各不相同,不同器件的单粒子效应测试系统有很大的区别。单粒子效应测试系统的结构由被试器件的类型和功能决定,GJB 7242—2011和QJ 10005—2008对单粒子测试系统提出了如下要求:
(1)能够对器件进行初始化设置;
(2)能够对器件进行功能测试,具有良好的测试覆盖性;
(3)具有单粒子效应的诊断和记录功能;
(4)具有自动复位或手动复位功能;
(5)具有良好的抗电磁干扰能力;
(6)具有可控的有效测试时间、电流监测和锁定损伤保护能力。
三、单粒子效应试验方法
单粒子试验的最终目的是获取器件的σ-LET 的关系曲线图,然后根据σ-LET 的关系曲线计算得到器件的 LET 阈值和饱和截面,最终利用得到的 LET 阈值和饱和截面计算出在轨单粒子事件率。
单粒子试验的基本过程如下:
(1)制定试验方案;
(2)试验前的准备工作;
(3)选择合适的离子,进行单粒子试验;
(4)计算单粒子事件截面;
(5)根据试验数据曲线,得到LET阈值和饱和截面,并计算在轨翻转率。
1.制定试验方案
GJB 7242—2011 和 QJ 10005—2008 只是进行单粒子试验的通用要求,不可能包含所有器件的所有试验要求,而且不同类型器件的单粒子效应不同,其试验源的选用、测试系统等方面也不同。因此,针对具体器件进行单粒子效应试验时,需要在试验前制定详细的试验方案。试验方案至少应该包含以下内容:
1)器件的结构、功能和需要测试的单粒子效应类别
器件的结构和功能决定器件单粒子效应的试验类别,且器件单粒子效应的具体定义是进行单粒子试验的基础。器件单粒子效应的具体定义,指什么现象是单粒子翻转效应,什么现象是单粒子功能中断效应,什么现象是单粒子锁定效应等等。
试验方案中应明确需要测试的单粒子效应类别。
2)模拟源及试验用离子的选择
单粒子效应地面模拟源主要有以下 3 类:重离子加速器、锎源、激光模拟源。由于锎源粒子单一、离子射程有限,激光模拟源等效性有待进一步研究、难以测量截面、无法穿透金属等原因,单粒子效应试验源推荐使用重离子加速器。
单粒子效应试验对加速器的基本要求如下:
(1)离子具有高的能量,足够的射程(Si中射程大于30μm);
(2)可以提供多种离子,可以提供宽广的LET范围;
(3)均匀束流(不均匀性小于10%);
(4)弱束流诊断和调节能力;
(5)快速更换LET(快速更换离子种类和能量);
(6)快速更换样品;
(7)良好的真空。
国内的重离子加速器有两类:中国原子能科学研究院的串列静电加速器和中国科学院近代物理研究所的回旋加速器。
中国原子能科学研究院的 HI-13 串列静电加速器(见图 5)可以加速能量连续可变的离子,可以提供从氢到金的 40 多种离子束流。该加速器进行重离子单粒子效应模拟试验的优点是能量连续可调,可以快速改变离子的种类和能量(一般情况下,1 小时内可以完成离子的转换)。但是该加速器提供的离子的能量相对较低,离子的射程一般较短,难以提供射程满足要求的高原子序数的离子。一般情况下,可以提供Si中射程大于30μm的离子的LET值最大为59左右,离子为银(Ag)。因此,选用HI-13 串列静电加速器进行单粒子效应试验时,必须在真空中进行。

图5 HI-13串列静电加速器
中国科学院近代物理研究所的 HIRFL 回旋加速器(见图 6)也可加速能量可变的多种离子,但是相对于串列静电加速器来说,其改变离子的种类和能量的时间较长(一般情况下,一个单粒子效应试验周期内只提供一种 LET 的离子)。回旋加速器的优点是可以将离子加速到很高的能量,加速离子的最大能量可超过 1GeV,加速离子的射程长。对于某些粒子(如Xe、Bi)可以在大气中进行,因此,可以提高试验效率。

图6 HIRFL回旋加速器
鉴于国内目前加速器的能力和特点,通常情况下,单粒子效应试验时,低LET的离子在HI-13串列静电加速器进行;而高LET的离子的单粒子试验在HIRFL回旋加速器进行。
确定试验源以后,需要根据器件的结构性能确定试验离子的种类和数量。单粒子试验的目的是通过试验获得单粒子截面σ-LET 关系曲线,并根据关系曲线进行单粒子事件率的预估,因此,需要选择合适的、足够的有效LET数据点。如果选取过少,所拟合得到的单粒子截面σ-LET 关系曲线误差过大,不够准确。一般情况下,为了得到单粒子截面σ-LET 关系曲线,至少选用具备 5 种以上不同的有效 LET 值的离子,并且离子的有效 LET 应能覆盖被试器件从刚开始出现单粒子事件到单粒子事件达到饱和截面所对应的LET范围。对于器件的单粒子时间LET阈值范围可以通过摸底试验获得,也可以参照与被试器件结构、工艺最接近的器件的单粒子试验数据进行估计。
另外,应在试验方案中确定离子的入射角度、注量率,以及每种离子的辐照总注量。
3)单粒子效应类型和检测系统
在单粒子试验过程中,测试器件的单粒子效应是一项复杂的技术,不同的器件类型具有不同的单粒子效应,如存储器类的单粒子翻转、DC/DC 器件的单粒子瞬态和单粒子烧毁等。而且,对同一器件,不同的测试方法或不同的测试程序,其测试结果往往不相同,甚至相差很大。
因此,需要在试验方案中确定需要测试的单粒子效应、方法和程序。在下一节中将会给出几种不同类型器件的单粒子效应测试方法。
4)试验流程
单粒子试验流程可以参考图3和图4制定。
2.试验前的准备工作
1)样品的准备
由于重离子加速器加速的离子的能量和射程的原因,进行单粒子试验的样品在试验前应进行开帽。如果被测器件的芯片表面具有保护层,应该去除这种保护层,以保证入射粒子在芯片中具有足够的射程。
为防止芯片在开帽过程中损坏,开帽后的样品应该进行电参数测试,只有测试合格的样品才能进行单粒子试验。
2)电缆及试验测试板的准备
单粒子试验通常在真空罐中进行,试验时,需要通过电缆和真空密封插头将试验测试板与外部的测试系统连接。试验板和电缆需要满足以下条件:
(1)试验板和电缆的尺寸、质量满足真空罐的要求;
(2)连接电缆满足真空罐的硬件接口要求;
(3)试验板和电缆不含吸附气体严重的材料;
(4)试验板的安装孔位符合真空罐的要求;
(5)保证试验板上的除被测器件外的其他元器件不受辐照的影响;
(6)试验板和电缆具备良好的抗电磁干扰能力。
3.进行单粒子试验
进行单粒子试验的一般步骤如下:
(1)试验测试系统的安装;
(2)安装完毕后,进行系统功能验证,以保证系统的正常;
(3)靶室(真空罐)系统抽真空;
(4)调节样品位置,开始辐照试验。
辐照前应获取束流均匀性数据,保证束流均匀性符合要求;辐照过程中,测试系统监测被测器件发生的单粒子效应,束流测量系统实时监测入射粒子的注量率及入射总注量,记录相应的单粒子效应现象、数据和辐照时间。
在试验过程中,选取试验方案中规定的离子种类进行试验,所获得的有效LET数据点至少为5个。
4.试验后数据处理
根据离子注量率监测系统记录的数据,计算垂直入射到某一器件表面的总离子注量Φ。绘制出单粒子翻转或闭锁截面随LET值变化的关系曲线,即器件的单粒子翻转或闭锁响应曲线。对重离子测试而言,如果离子入射方向与器件表面有一定的角度,则有效LET值为垂直入射时的LET值除以入射角的余弦。

如果入射角度发生变化,有效注量也随之改变。测量到的离子注量应当修正,单粒子效应截面用下式计算:

式中,N为翻转数,φ为垂直于离子束测量到的离子注量。
然后根据得到的单粒子事件截面σ与入射离子 LET 的关系曲线,以及器件实际使用的宇航空间辐射环境参数,进行在轨单粒子事件率的预估。目前国内外常用的在轨单粒子事件率预计的软件有Space radiation和CRÈME软件等。
图7所示为国外某型号DAC 的单粒子效应数据点,以及采用威布尔函数(Weibull)拟合得到的单粒子效应全截面曲线。

图7 国外某型号DAC单粒子效应全截面曲线
四、单粒子效应试验案例
1.单粒子锁定效应测试方法
单粒子锁定效应表现为器件的电源电流持续增加,直至该器件由于过流烧毁。因此,单粒子锁定效应的测试一般采用监测电源电流突然增加且超过规定的最大电流值方式来进行检测。
单粒子锁定试验中,“规定的最大电流值”具体为多少需要根据器件的性能而定,目前通常的做法为器件正常工作下最大电流值的1.5倍。
另外,单粒子试验过程中导致电源电流增加的原因除单粒子锁定外,可能还有单粒子功能中断和单粒子翻转等。和单粒子锁定引起的电流增加的区别在于,单粒子功能中断和单粒子翻转引起电源电流的增加可以通过软复位(不断电)使电流恢复到正常水平,但是单粒子锁定只能通过断电重启才能恢复。
因此,单粒子锁定效应的判据一般定义为器件的电源电流突然增加,超过规定的最大电流值,并且通过软复位无法恢复,只能通过断电重启才能恢复时,判定为单粒子锁定。
需要注意的是,单粒子锁定试验时,器件需工作在正常工作状态,且需工作在最高工作频率。
2.SRAM器件的单粒子翻转测试系统
图8所示为SRAM器件单粒子翻转效应测试系统示意图。单片机控制被试SRAM器件的读/写,以及测试图形与预定图形的对比,并将比对结果发送给上位机并在计算机屏幕中显示出来。
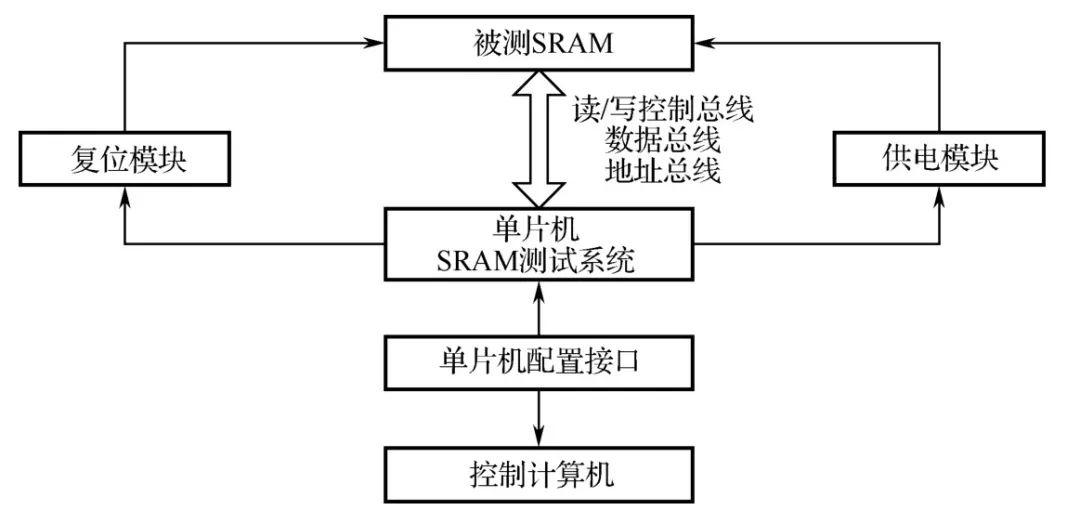
图8 SRAM单粒子翻转测试系统示意图
SRAM器件的单粒子翻转测试可以分为静态测试模式和动态测试模式两类,具体如下:
1)静态测试模式
试验前器件预先写入特定的测试图形,试验开始后按顺序读出每个地址位的图形与预先图形进行比较,如果存在n不同,SEU翻转计数为n,通过USB数据传输到远程控制机上显示出来。数据出现翻转后,作为后续的基础状态,后续读出的数据与之比较,相同则没有翻转,如果存在m不同,SEU翻转计数为n+m。静态测试模式和动态测试模式的测试示意图如图8所示。
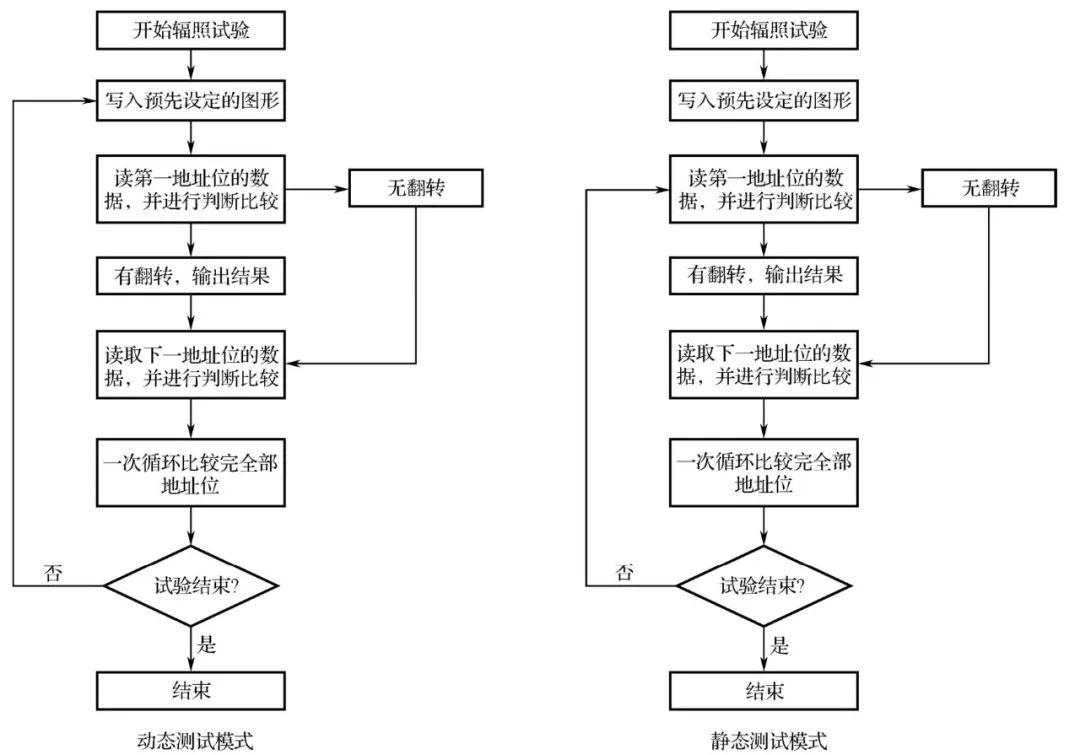
图8 SRAM器件SEU试验中,动态测试模式和静态测试模式示意图
2)动态测试模式
在动态测试模式下,单粒子辐照试验过程中,器件将周期性地进行图形的写入、等待、读出比较的操作过程,错误在读过程中被发现,在写过程中被纠正。
SRAM 器件预先写入的测试图形可全“0”、全“1”,以及“55”“AA”等,可以是单一的测试图形,也可以是多种测试图形。
存储类器件除 SRAM 外,还有 EEPROM、PROM、Flash 等。这些存储类器件的单粒子翻转的测试方法可以参照SRAM的测试方法进行。
3.DC/DC单粒子效应试验方法
DC/DC器件的单粒子效应主要有两种:单粒子瞬态和单粒子功能失效。
DC/DC 器件的单粒子瞬态指的是入射粒子引起 DC/DC 出现输出电压瞬时跳变(增加或减小)的现象,而且该瞬时跳变发生后 DC/DC 器件的输出电压即恢复正常。DC/DC 器件的单粒子瞬态引起输出电压的瞬时跳变的脉冲宽度一般较小,最小可以达μs级。
DC/DC 器件的单粒子功能失效是指入射粒子引起 DC/DC 不能正常工作的现象。该效应发生时,DC/DC 器件的输入模块输入电流将会发生异常,输出电压将会突然变为 0 或非正常值。
图9所示为DC/DC单粒子效应检测系统示意图。

图9 DC/DC单粒子效应检测系统示意图
DC/DC 器件的单粒子功能失效主要是通过实时监测电路模块的各输出端的输出电压,以及实时监测输入电源电流的方式来检测单粒子功能失效,当输出电压突然为 0 或非正常值,输入电源电流为非正常值时,表明器件发生单粒子功能失效。DC/DC 器件发生单粒子功能失效后,断电重启,DC/DC电源模块功能不正常。
DC/DC 器件的单粒子瞬态时通过实时监测器件各输出端的输出电压波形,当输出电压瞬态波形的幅度、脉宽超过规定的阈值时,认为发生单粒子瞬态。
4.DSP单粒子效应试验方法
图10所示为某型DSP(Digital Signal Processor,数字信号处理器)的单粒子翻转试验系统示意图。该型产品的单粒子翻转测试采用单机辅助控制法,测试计算机运行单粒子翻转测试软件,在辐照过程中对试验结果进行实时显示。受试器件安装在试验线路板的中央,工作频率为 160MHz。辐照过程中,受试器件将输出结果存入双端口存储器,试验线路板的FPGA 取出输出结果并进行实时检测,判断 SEU 和 SEFI 的发生。单粒子翻转测试包括内部程序存储器(IPM)、内部数据存储器(IDM)、指令集遍历和外设部件数据搬运 4 个项目,基本要求如下:
(1)至少能够对器件实际使用的功能进行测试;
(2)能够对被试验器件进行初始化设置;
(3)具备单粒子翻转(SEU)和单粒子功能中断(SEFI)的诊断和记录功能;
(4)具备数据的实时处理、存储和检索功能;
(5)具有自动复位和手动复位的功能;
(6)具有良好的抗电磁干扰能力。

图10 单粒子翻转和锁定测试原理图
1)IPM和IDM测试
该产品 IPM 和 IDM 各包含 512K 位 SRAM,采用动态模式进行测试,测试向量为“棋盘格”图案,测试流程如图11所示。辐照开始后,DSP测试代码用“棋盘格”图案完全填充IPM或IDM,然后将IPM或IDM的全部数据循环输出。测试系统实时监测输出结果的正确性和循环次数,并在测试软件中存储并实时显示单粒子翻转(SEU)和单粒子功能中断(SEFI)信息。当发生 SEU 时,测试系统记录 SEU,不中断数据输出;当发生 SEFI 时,则重启 DSP 测试代码。SEU 判据:输出数据与预期结果不一致;SEFI 判据:假设正常情况下将IPM或IDM的全部数据输出1次所需时间为t,如果在2t时间内未能完成1次全部数据输出,则判定为SEFI。
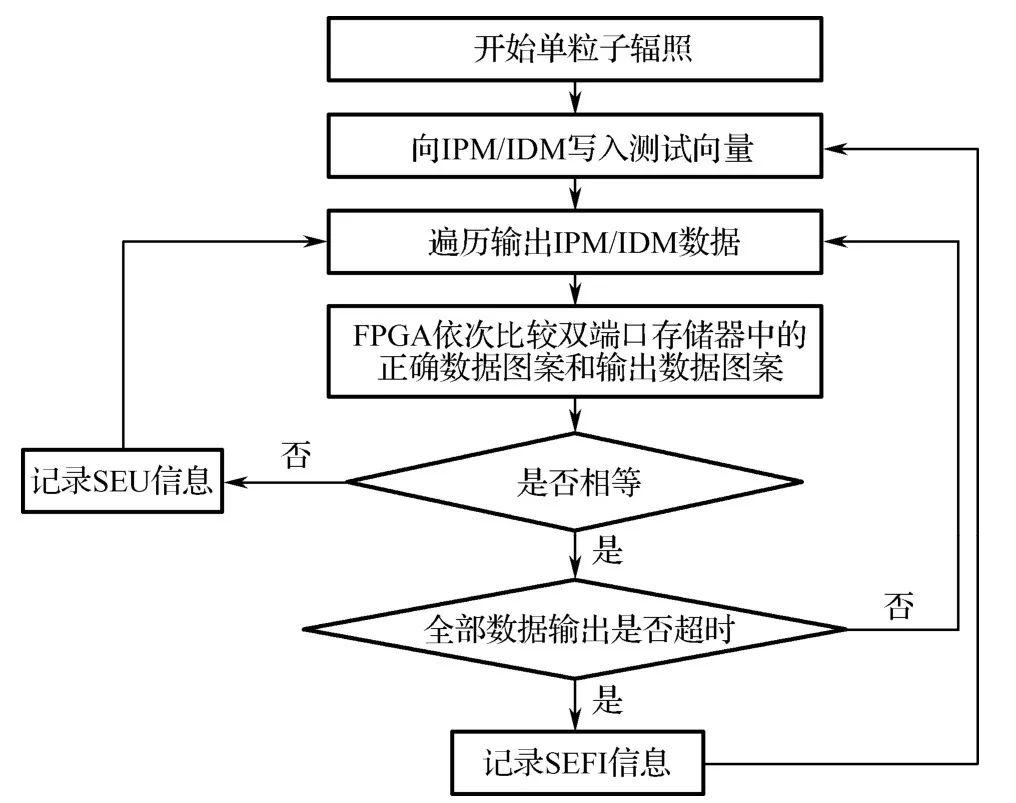
图11 IPM和IDM测试流程图
2)指令集遍历测试
指令集遍历测试运行DSP指令集遍历代码,将运算的结果存入双端口存储器,并置运算完成标志。FPGA 判断运算结果是否正确,将判断结果报告测试软件,然后启动新一轮测试循环。测试软件记录并实时显示 SEU 和 SEFI 信息。DSP 指令集遍历代码存储于外部存储器,包含TI 6000系列DSP所有指令,DSP配置为非Cache模式,不打开“Cache”功能执行(IPM和IDM测试已进行Cache利用的IPM和IDM部件的单粒子翻转测试)。测试流程如图12所示。SEU判据:运算结果错误;SEFI判据:假设正常情况下DSP指令集遍历代码运行1遍所需时间为t,如果在2t时间内未能完成1次循环,则判定为SEFI。

图12 指令集遍历测试流程图
3)外设部件数据搬运测试
外设部件数据搬运测试对应的DSP测试代码将64KB数据从双端口存储器开始,在各外设中搬运,最后存入双端口存储器,并置搬运完成标志。FPGA 判断搬运结果是否正确,将判断结果报告测试软件,然后启动新一轮测试循环。测试软件记录 SEU 和 SEFI。测试流程如图 13所示。SEU 判据:搬运结果错误;SEFI 判据:假设正常情况下外设部件数据搬运1遍所需时间为t,如果在2t时间内未能完成1次循环,则判定为SEFI。
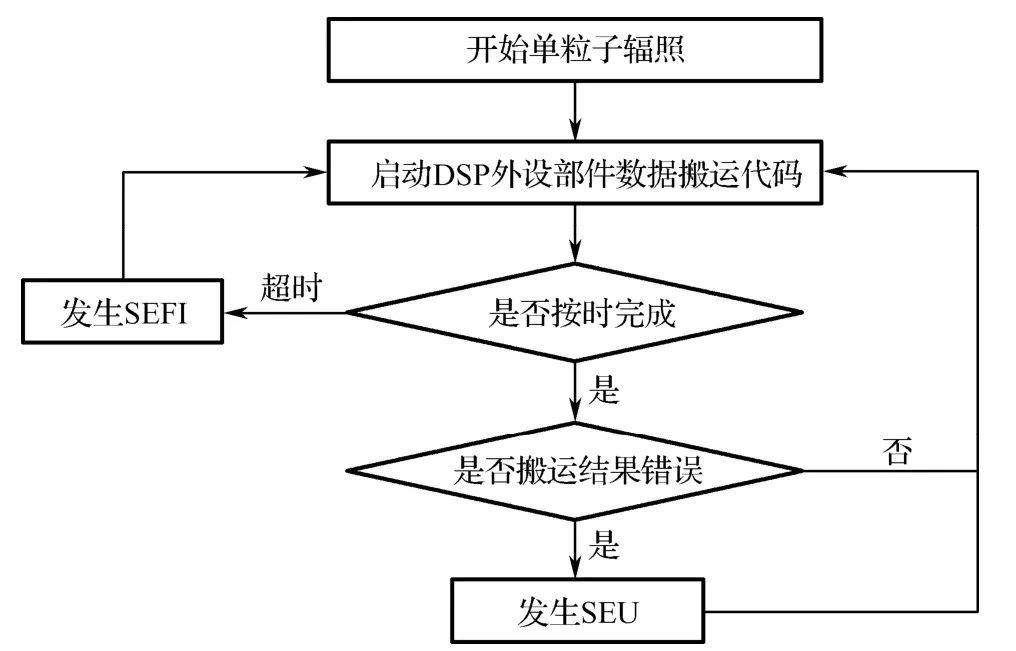
图13 外设部件数据搬运测试流程图

长按二维码识别关注我们

